シングルダイからMCMまで、多様なオプションに対応する卓越した技術力
今日のマイクロエレクトロニクス・システムでは、さまざまな要素がシステム全体の性能に影響を与えます。そうした状況では、半導体チップと同様、パッケージも性能に対する重要な役割を担うことになります。Teledyne e2v Semiconductorsはこのことを十分に理解しており、さまざまなパッケージング形態のSiPおよびICソリューションを市場に提供できる立場にあります。
半導体パッケージの豊富な選択肢
パッケージには非気密型と気密型があり、用途に応じて使い分けます。気密型パッケージは、液体やガス、汚染物質など、さまざまな要因からダイを保護します。また、パッケージは有機基板とセラミック基板のどちらにも対応します。
有機基板を使用すると、ダイやダイを封入するハウジングを薄くできるので、よりコンパクトで薄型のソリューションが実現でき、クリアランスを削減して基板面積を節約できます。逆に、セラミックを使ったパッケージは気密性が高いので、宇宙用に最適です。
気密型の利用は、過酷な環境下で起こりうる問題の予防に効果的です。セラミック基板は、有機基板よりも半導体チップに近い熱特性を備えています。これにより、熱の変化によるダイのたわみ(クラックの可能性)を防ぎ、長期的な信頼性を高めることができるというメリットがあります。
フリップチップの機能
パッケージは、フリップチップ用、あるいはワイヤーボンディング用のダイ配列が可能です。どちらが適切かは、基板上のスペースや、I/Oの密集度、コストの制約によります。少量生産のフリップチップソリューションを見つけるのは非常に難しいため、ここでもTeledyne e2v Semiconductorsは際立つ存在となっています。そのような機能を持つベンダーは非常に少なく、仮に見つかったとしても小型のデバイスにしか対応できないことが多いのです。当社では、フリップチップによる300mm径のウェハの自動加工が可能です。最大560mm2のダイサイズに対応し、最大150μmのピッチで10,000個ものバンプ形成ができます。
圧倒的な技術力
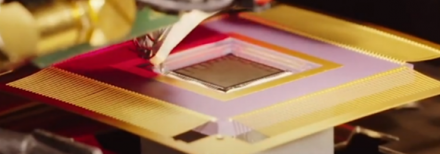
当社のワイヤーボンディング技術は、単一ダイのソリューションに加え、異種ダイを使用したマルチチップモジュール(MCM)の作成も可能で、必要に応じて異なる性能特性をカバーすることができます。接合方法としては、アルミニウム(Al)ワイヤのウェッジボンディングと金(Au)ワイヤのボールボンディングの2種類が採用されており、最大2000本までの配列が可能です。
より大型のダイへの対応
Teledyne e2v Semiconductorsのチームが持つ大型ダイアセンブリ技術は、FPGAを設計に組み込む企業にとって大きな価値があります。さらに、かなり長尺のダイを提供できることも他社にはない当社の特徴です。長尺のダイは曲げると破損する可能性があり、非常に厳しい精度での組み立てが要求されるため、高度な組み立て技術が必要なのです。また、配置の精度の高さも当社の強みの一つで、精密な品質のパッケージングソリューションを提供することができます。
完成後はパッケージの様々な要素を検証する必要があるため、サプライヤに必要なスキルが備わっていることが重要になります。Teledyne e2v Semiconductorsの製造サービスはワンストップで提供されるため、ダイをパッケージングした後、広範囲にわたる試験や検査を行うことが可能です。目視検査による詳細な特性評価と精査に加え、超音波顕微鏡検査と幾何学的測定も実施します。詳細情報については、以下のフォームからお問い合わせください。
お問い合わせ
すぐにビジネスを支援するには、以下の情報を入力してください

